- 入驻时间: 2017-03-06
- 联系人:张婧
- 电话:0512-67089211
-
联系时,请说明易展网看到的
- Email:suz@tamasaki.com.cn
- Stucchi思多奇
- NITTO KOHKI日...
- Sankei
- KYOWA协和工业
- DIT东日技研
- AITEC艾泰克
- SIGMAKOKI西格玛...
- REVOX莱宝克斯
- CCS 希希爱视
- SIMCO思美高
- POLARI0N普拉瑞
- HOKUYO北阳电机
- SSD西西蒂
- EMIC 爱美克
- TOFCO东富科
- 打印机
- HORIBA崛场
- OTSUKA大冢电子
- MITAKA三鹰
- EYE岩崎
- KOSAKA小坂
- SAGADEN嵯峨电机
- TOKYO KEISO东...
- takikawa 日本泷...
- Yamato雅马拓
- sanko三高
- SEN特殊光源
- SENSEZ 静雄传感器
- marktec码科泰克
- KYOWA共和
- FUJICON富士
- SANKO山高
- Sugiyama杉山电机
- Osakavacuum大...
- YAMARI 山里三洋
- ACE大流量计
- KEM京都电子
- imao今尾
- AND艾安得
- EYELA东京理化
- ANRITSU安立计器
- JIKCO 吉高
- NiKon 尼康
- DNK科研
- Nordson诺信
- PISCO匹斯克
- NS精密科学
- NDK 日本电色
- 山里YAMARI
- SND日新
- Otsuka大塚电子
- kotohira琴平工业
- YAMABISHI山菱
- OMRON欧姆龙
- SAKURAI樱井
- UNILAM优尼光
- ONO SOKKI小野测...
- U-Technology...
- ITON伊藤
- chuhatsu中央发明...
OTSUKA大塚电子关于了解薄膜厚度评估 测量方法
1. 简介
在城市中看到智能手机和平板电脑已经不是什么稀奇了,但事实上,薄膜技术在这些突飞猛进的背后有着巨大的影响。 换句话说,半导体是高科技器件的代表,LCD由薄膜堆叠技术组成。 此外,只要想想你周围的事物,你就会意识到薄膜作为核心技术正在变得不可计数。
• CPU、存储器和其他半导体器件
、LCD 和其他显示设备
、磁盘、光盘和其他存储介质
、镜头、在显示设备表面施加的无反射膜
、防潮膜等聚合物产品的表面改性膜等。
除了这些器件的薄膜制造设备外,测量和评估设备也变得至关重要。
2. 薄膜的测量方法
触针是直接和*原始的方法,以及使用电子显微镜观察横截面的方法,误差很小,但另一方面,存在对样品造成致命损害的风险。 因此,它不适合质量控制。
另一方面,使用分光光度计的方法很容易,并且可以以非接触式测量,只要知道折射率,就可以高精度地测量,但由于折射率因沉积条件而异,因此需要以某种方式测量它。 由于折射率是光具有波的性质,并且由于与透射物质的相互作用而产生的现象,因此光谱厚度测量与采用相同方法的折射率测量是不可分割的。 换句话说,由于薄膜的折射率和吸收系数是由材料特有的物理性能决定的,因此从薄膜厚度测量的角度来看,这是使分析复杂化的因素,但从了解薄膜物理性能的角度来看,这也是一个非常重要的方法。 特别是在半导体材料中,由于其组成和杂质的比例很重要,因此当薄膜成分发生变化或沉积条件发生变化时,它也会成为监测器。
此外,由于在光谱中增加了偏振分析功能,可以更详细地观察光与物质之间的相互作用,因此利用这一原理的分光椭圆计先进的薄膜厚度测量装置也已商业化。 该设备不仅能够高精度地测量更薄的薄膜和折射率本身,而且还能够对薄膜进行各向异性分析。
现在,在下一节中,我想更详细地解释光谱厚度分析的原理。
3. 光干涉效应的薄膜厚度分析
使用光干涉效应的薄膜厚度计*常见的方法是峰谷方法(PV 方法)。 原理很简单,它利用了在膜表面反射的光和背面反射的光相互干扰,当光的相位匹配时,强度增加,当偏移时减弱。 因此,在光谱上观察到反射强度随波长变化而变化的干涉模式。 具体来说,PV方法根据这种图案的峰值和谷波长确定薄膜厚度。
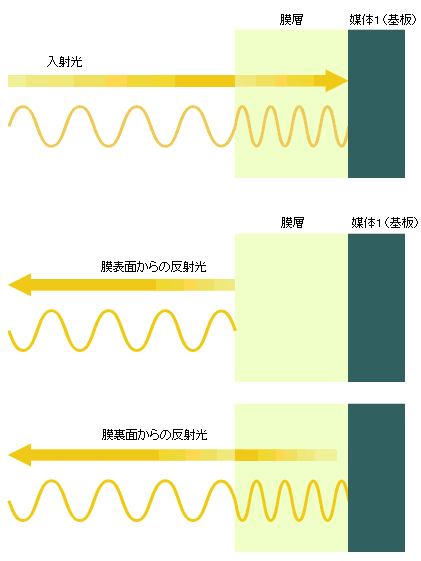
由于光通过膜层两次合成,因此 n= 折射率和 d = 厚度仅产生**个光路差。 这是因为光在膜层中的传输速度是n倍,这就是为什么需要折射率的原因。 *后,重要的是反射光的相位是如何变化的。 也就是说,在折射率较大的介质上反射时,相位不会发生变化,因此波长的整数倍为光路差 2nd 的波长为峰值。 相反,在低介质上反射会导致 180 度偏差。 换句话说,在空气/膜/空气组合的背面,相位偏移180度,使波长的整数倍光路差2nd成为谷。 如果折射率已知,则根据这种关系确定厚度。 此外,折射率的大小也可以根据光路差 2nd 的整数倍的波长是峰值还是谷值来确定。
此外,在峰值和谷以外的波长上,通过弯曲拟合每个波长的反射强度和理论值,可以确定折射率以及薄膜厚度值。
4.复杂折射率分析
薄膜的光吸收系数被视为消光系数 k。 化学分析中使用的吸光度的差异通过乘以波长,与折射率一样无尺寸化。 此外,在电磁波的理论方程中使用折射率 n 和消光系数 k,将复杂折射率 N 表示为简化公式,如下式所示。 与真空中相比,光在折射率为 n 的介质中移动得较慢,当消光系数增加时,强度会衰减。
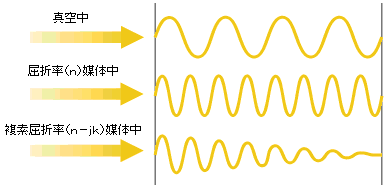
N=n-jk
如果仅测量薄膜厚度,则消光系数只会增加参数,使分析变得困难,因此通常使用近红外光测量测量光源,并在没有吸收的波长下进行测量。 在液晶滤色片中,着色是质量的重要因素,因此可能会增加着色,特别是由于干扰,甚至改变显示设备的色调。 此外,在半导体领域,k的测量变得越来越重要,因为它是晶体内部电子状态水平的重要指标。
此外,由于绝缘膜的着色会导致器件性能问题,因此需要设置沉积条件,以降低 k。
消光系数 k 可以从反射光谱中**确定,如果光谱形状已知,则可以利用克拉默斯-克罗尼希在折射率和消光系数之间的关系,从而减少参数。 但是,当光谱形状发生变化时,测量精度并不高。 此外,如果光谱模式未知,则无法从反射光谱中确定 k。
为了高精度地测量薄膜的消光系数,测量的透射光谱必须与光谱椭圆光谱和反射光谱相结合。 这种方法相当常见,但缺点是,它**于透明基板。
硅基板的折射率得到了很好的研究,文献也很多,但尽管如此,文献中的数字却大相径庭。 由于通常的沉积是在Si基板上进行的,因此,即使折射率和消光系数不同,由此产生的反射光谱和光谱椭圆光谱也完全符合理论计算。 近年来,外延生长的Si膜被粘贴在绝缘基板上,并用于半导体基板,由于光在这种Si膜中透射,消光系数的差异直接反映在光谱中。 换句话说,即使使用文献值,也不可能准确分析测量光谱,从而导致与文献值之间的偏差。 换句话说,文献值具有相当大的误差。
5. 椭圆测量
这种测量方法的历史非常悠久,可以追溯到19世纪。 近年来,光谱椭圆法之所以如此流行,是因为它在分析方法方面取得了长足的进步。 换句话说,一种新的旧测量方法就是椭圆测量。
在单波长椭圆体中,薄膜厚度值由椭圆体参数(如 tan_ 或 * )简单计算,但多层膜使模型表达式变得过于复杂,因此不容易确定。 因此,通过改变波长、进行参数拟合和多变量分析,可以分析多层膜,但近年来,由于个人电脑的进步大大缩短了分析时间,因此得到了广泛的应用。
椭圆具有椭圆的含义。 由于光是波,当直行方向的偏振光的相位偏移 90 度时,它变为圆偏振光。 如下图所示,从光的行进方向看偏振方向,它随着时间的推移向左 旋转。 如果相位偏移不是 90 度,则为椭圆。 偏振分析称为椭圆偏振分析仪,因为它分析椭圆偏振光。 光具有波的性质。 换句话说,光谱椭圆测量充分利用了三种信息:强度、相位和波长。

为什么分析椭圆偏振光需要薄膜厚度? P 波是与反射面法线平行的偏振光,S 波是与法线成直角的偏振分量的名称。 对于薄膜厚度测量,光谱椭圆测量始终通过具有恒定入射角的反射测量进行。 除了 P 波和 S 波的表面反射率不同外,反射率比还受到光干扰的影响,因此为 tan。 此外,由于薄膜介质中光的进度速度不同,会产生相位差。 此外,由于P波和S波在反射过程中的相位变化不同,因此它们会产生相位差。 因此,相位差也会随薄膜厚度而变化。 这是光谱椭圆法测量薄膜厚度的原理。
在没有公式的条件下解释爱立浦奏的原理是极其困难的,我认为阿扎穆斯的电磁解释是*容易理解的。 换句话说,遵循公式是*准确、*容易理解的,如果不使用公式,则从光谱形状解释可能更容易理解。
光谱椭圆法的折射率和薄膜厚度测量是一种非常敏感的方法,但如果薄膜厚度较大,则光谱变化会表现出细微的 n 差异。 利用这一特性,我们经常讨论膜界面的状态和膜纵向密度梯度,但这种详细分析存在一些风险。 这是因为有许多因素可以改变光谱,特别是在很大程度上取决于膜表面的状态,因此可能不清楚哪个是真正的膜模型。
光谱椭圆法也有其局限性。 当薄膜的薄膜约为几纳米时,它大约是光波长的百分之一,需要nd,但很难分离两者。 这种缺点也是光谱学的一个常见问题。
6. 结构分析
光谱法不仅允许单层膜,还允许更复杂的结构分析。
例如,对于高速、节能的 SOI(Si 夹层 SiO2 结构),表面层的 Si 和中央 SiO2 层的厚度都会影响质量,但光谱法允许测量此类多层结构中每一层的薄膜厚度。
此外,退火的ITO(透明导电膜)提高了透明度和导电性,但膜质量可能会在加热表面和难以传递热量的基板侧逐渐改变。
也可以分析这种膜质量厚度方向的阶段性变化。
此外,还可以分析折射率因液晶方向而异的材料的三维折射率,并分析特定区域内薄膜厚度的不均匀性(不均匀性)。
我们非常重视这些结构分析,并专注于开发。
此外,在分析算法方面,我们每天都在努力改进和开发,以满足对*新技术的需求。
阵容列表









